下一代EUV光刻机,要来了
ASML控股公司的一位高管告诉路透社,下一代芯片制造机已经准备就绪,制造商可以开始将其投入大规模生产,这对芯片行业来说是一大步。
这家荷兰公司生产全球唯一商用极紫外光刻(EUV)设备,这是芯片制造商的关键设备。这款新设备将帮助台积电以及英特尔等芯片制造商.数据显示,通过消除芯片制造过程中几个成本高昂且复杂的步骤,下一代EUV光刻机可以生产出功能更强大、效率更高的芯片。
ASML首席技术官马可·皮特斯周三告诉路透社,ASML计划于周四在圣何塞举行的技术会议上发布这些数据,这代表着一个重要的里程碑。
ASML 花费数年时间开发出昂贵的下一代工具,因为芯片制造商一直在努力确定何时开始将其用于大规模生产才具有经济意义。
但鉴于当前一代 EUV 工具在制造复杂 AI 芯片方面已接近技术极限,下一代机器(称为高数值孔径 EUV 工具)对于 AI 行业至关重要,可以改进 OpenAI 的 ChatGPT 等聊天机器人,并帮助芯片制造商按时交付其 AI 芯片路线图,以满足激增的需求。
新工具造价约为 4 亿美元,是原 EUV 机器造价的两倍。
据皮特斯称,ASML的数据显示,高数值孔径极紫外光刻机(High-NA EUV)的停机时间目前非常有限,已生产了50万片餐盘大小的硅晶圆,并且能够绘制出构成芯片电路的足够精确的图案。综合这三项数据,表明这些设备已准备好投入制造商使用。
“我认为现在是时候关注已经发生的学习周期数量了,”他说道,指的是客户对机器进行的测试次数。
尽管这些技术已经成熟,但企业仍需要两到三年的时间进行足够的测试和开发,才能将它们整合到生产制造中。
“(芯片制造商)拥有所有必要的知识来验证这些工具的有效性,”皮特斯说。
皮特斯还表示,公司目前的正常运行时间约为80%,并计划在年底前达到90%。他指出,ASML计划发布的成像数据足以说服客户用单步高数值孔径(High-NA)工艺取代老一代设备的多步加工。这些设备已加工了50万片晶圆,使公司得以解决许多技术难题。
为什么需要High NA?
过去两年是高数值孔径极紫外光刻技术发展的重要篇章。随着首批系统交付客户,以及ASML与imec联合成立的高数值孔径极紫外光刻实验室的启动——这为整个生态系统提供了早期探索其潜力的机会——这项技术正获得真正的发展动力。迄今为止,高数值孔径极紫外光刻技术展现出巨大的潜力,有望实现其在尺寸缩小、工艺简化和设计灵活性方面的承诺。
释放这些能力源于一种整体方法,该方法同时优化材料和图案化工艺、掩模和成像技术、光刻增强技术(例如光学邻近校正 (OPC))、计量和检测以及设计。这是imec -ASML高数值孔径EUV生态系统内强大合作的成果,该生态系统涵盖了领先的芯片制造商、设备、材料和光刻胶供应商、掩模公司以及计量专家。
本文探讨了高数值孔径 EUV 光刻技术的关键驱动因素,并重点介绍了光刻和图案化生态系统发展中的转折点,从而实现了该技术的实验验证。
高数值孔径 EUV 驱动因素1:更高的分辨率和图像对比度
与 0.33NA EUV 光刻相比,0.55NA EUV 光刻的数值孔径 (NA) 提高了 67%,因此有望获得更高的分辨率。
光刻系统的分辨率反映了该工具打印和分辨特定间距或关键尺寸 (CD) 特征的能力。瑞利方程提供了三个提高分辨率的途径:使用更小的 k1 因子、使用更短波长的光以及提高系统投影镜头的数值孔径 (NA)。k1 因子取决于许多与芯片制造工艺相关的因素,为了提高分辨率,通常会尽可能接近其物理极限 0.25。NA 控制用于成像的光量(更准确地说,是镜头捕获的衍射级数)。低 NA (0.33) 和高 NA (0.55) EUV 光刻均使用波长为 13.5nm 的光。但高 NA EUV 的NA 值比低 NA EUV 高 67%,这使其在分辨率方面具有明显优势,最终有望分辨出间距小至 16nm(或 CD 为 8nm)的线条。
2024年,imec在ASML-imec高数值孔径EUV光刻实验室中,利用0.55NA EUV光刻扫描仪(TWINSCAN EXE:5000)实现了16nm间距线/空的单次打印图像,创造了世界纪录[5,6]。这些图像打印在专为高数值孔径EUV光刻优化的金属氧化物光刻胶(MOR)上。同样,接触孔(打印在化学放大光刻胶(CAR)上)和柱状结构(打印在MOR上)也展现了令人瞩目的24nm间距(中心距)分辨率。
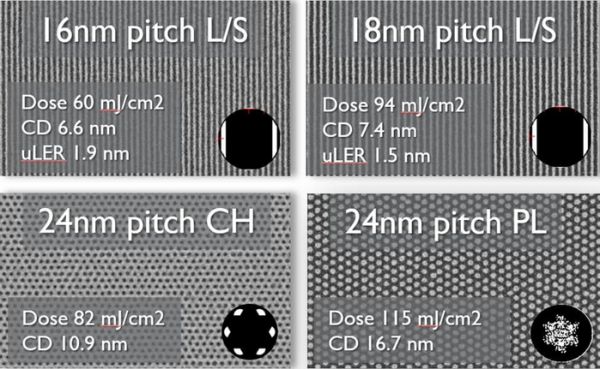
然而,最终分辨率仅仅是一种“光学”上的承诺,它反映的是图像在照射到晶圆之前空中成像的质量。在晶圆曝光过程中,空中成像会在光刻胶中形成图案,这些图案在显影后会被进一步蚀刻到下层。因此,最终图案化结构的分辨率也取决于图案化过程中使用的材料(光刻胶、下层、硬掩模等)和蚀刻工艺的性能。工艺限制也可能影响300mm晶圆上结构的良率。
因此,高数值孔径极紫外光刻技术(High NA EUV)实现工业相关图案化结构的分辨率极限将大于16nm间距。先进的光刻材料研发工作,特别是新型材料和磁光刻(MOR)技术的研发,对于使图案化技术的分辨率尽可能接近高数值孔径极紫外光刻技术的理论极限至关重要。
2025 年,imec 展示了20nm 间距的金属化线结构,该结构适用于工业大马士革金属化工艺,并展示了采用直接金属蚀刻(DME) 金属化方案获得的20nm 和 18nm 间距的 Ru 线。这种极高的分辨率是通过整体方法实现的,该方法涉及对光学邻近校正 (OPC) 技术、光掩模、光刻胶、底层和蚀刻工艺及材料的协同优化。
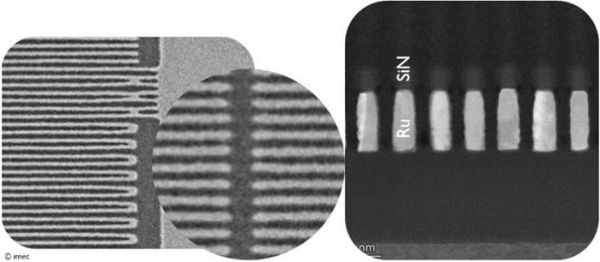
高数值孔径(NA)极紫外(EUV)光刻扫描仪中,投影透镜接收到的光线具有比低数值孔径(NA)EUV扫描仪更多的衍射级次。这增强了空中图像的对比度——即光线穿过光掩模后明暗区域之间的强度差异——这也是其分辨率更高的原因。当光刻胶曝光于对比度更高的图像时,印刷特征具有更好的局部关键尺寸(CD)均匀性(LCDU),并且粗糙度更低。这一结论已通过对各种29nm间距的六边形孔和柱状结构的实验验证,结果表明,与0.33NA印刷特征相比,LCDU提高了18%至42% 。
高图像对比度还能降低在光刻胶上以足够质量印刷图案所需的剂量尺寸比。这反过来又可以缩短曝光时间,从而提高扫描仪的吞吐量并降低工艺成本。对于间距为 29nm 的孔和柱状图案,使用 0.55NA EUV 光刻技术时,剂量尺寸比可降低约 60% 。
高数值孔径 EUV 驱动因素2:工艺简化
芯片行业可能会辩称,20nm 的特征尺寸也可以使用低数值孔径 (Low NA) 的极紫外 (EUV) 光刻技术进行图案化。诚然如此,但这只能通过复杂的多次曝光步骤来实现。这涉及到将芯片图案分割成两个或多个“更简单”的掩模,从而增加制造时间、降低良率、增加碳排放并提高成本。而高数值孔径 (High NA) 的极紫外光刻技术提供的高分辨率则减少了多次曝光的需求,使得最小的芯片特征尺寸能够在一次曝光中完成印刷。
对于A14 和 A10 逻辑节点,最关键的金属层(即 M0 和 M2)的要求非常高:线/间距 ≤20nm,用于中断线的密集端对端 (T2T) 结构(行业目标是 T2T 的 CD ≤15nm,LCDU ≤3nm),以及中心距 ≤30nm 的随机通孔。0.33NA EUV 光刻需要 3-4 个掩模才能完成这些特征的图案化,而 0.55NA EUV 光刻只需一次曝光即可完成,实验已证实这一点。Imec 还可以克服实现良好T2T 控制的挑战:通过协同优化光源、掩模(使用低 n 相移掩模)、光刻胶和刻蚀工艺(使用定向刻蚀技术),可以实现 13nm T2T 结构低于 3nm 的目标 LCDU。

高数值孔径极紫外光刻技术能够省去复杂的多重曝光步骤,使其成为未来DRAM节点(例如32nm (D1d) 和28nm (D0a) DRAM)发展路线图的关键技术。对于这些节点,实验已证实使用高数值孔径极紫外光刻技术对BLP/SNLP层(包含位线外围和存储节点焊盘的层)进行图案化的可行性[4]。0.33NA极紫外光刻技术至少需要三个掩模才能完成BLP/SNLP层的图案化,而0.55NA极紫外光刻技术仅需一个掩模即可完成相同的任务。
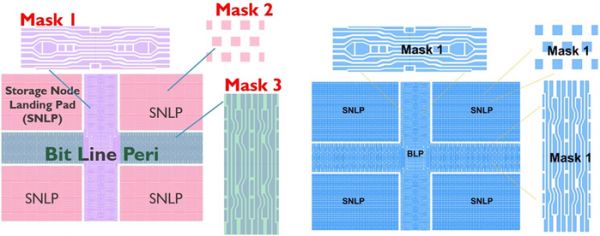
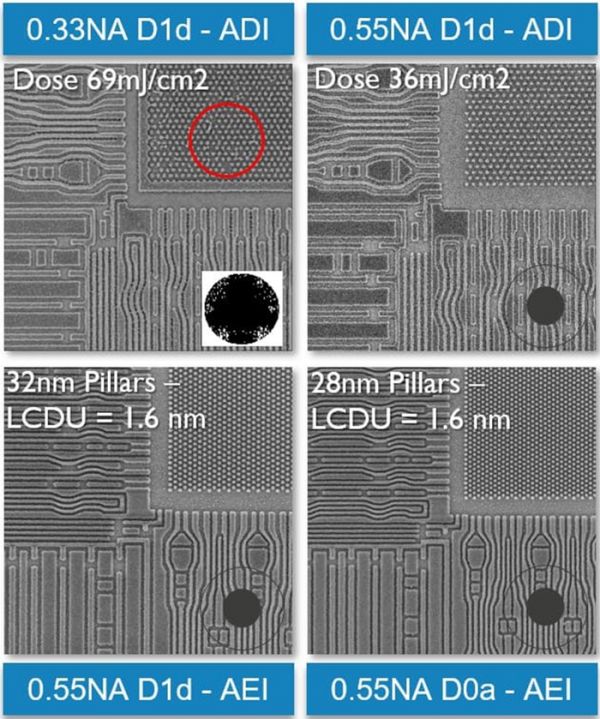
高数值孔径 EUV 驱动因素 3:设计灵活性
在2000年代中后期,先进逻辑芯片的设计在最关键的层中从二维电路布局转向了一维曼哈顿布局。这种设计上的“代价”是为了扩展193nm浸没式光刻技术的应用范围,使其能够实现更低k1值的单次曝光和多次曝光,从而为0.33NA EUV光刻技术的成熟做好准备。在二维双向设计中,曼哈顿几何结构用于在垂直和水平方向上形成电路。相比之下,一维或单向设计则仅在每一层中沿垂直或水平方向排列结构。尽管一维曼哈顿布局能够提供高密度的表示,但它也存在一些局限性。例如,当需要将一条金属线与相邻的金属线连接时,必须增加一层带有通孔的结构——这不仅会增加晶圆成本,还会增加电流路径的长度。
高数值孔径极紫外光刻技术带来的分辨率飞跃,使1.5D和2D曼哈顿设计得以重新应用,甚至能够引入曲线几何形状和路径。这不仅为芯片设计人员提供了更大的灵活性,从而提升功耗和性能,而且还有可能减少面积消耗或层数,进而降低成本。
结论
开发高数值孔径(High-NA)专用光刻和图形化技术需要采用整体方法,才能验证其三大优势:相较于0.33NA EUV光刻技术,分辨率和图像对比度显著提升;通过单次图形化简化工艺;以及通过1.5D、2D和曲面设计实现设计灵活性。Imec及其合作伙伴生态系统正不断突破这些技术的极限,开发下一代高数值孔径EUV光刻和图形化技术,为业界提供均衡的选择。目前,研发工作正致力于解决诸如景深提升、随机缺陷抑制和拼接技术等挑战。
因此,高数值孔径极紫外光刻技术将成为未来先进技术(例如先进人工智能芯片、高性能计算和下一代存储器)的关键推动因素。它被视为满足人工智能和数据中心应用需求的必要条件,因为这些应用需要硬件快速发展。该技术在实现《欧洲芯片法案》中关于推动2纳米以下逻辑技术节点的目标方面也发挥着关键作用。
(来源:编译自imec)
发布于:安徽
相关推荐
下一代EUV光刻机,要来了
下一代EUV光刻机即将爆发
下一代EUV光刻机,万事俱备?
EUV光刻机的全球战争
下一代光刻机,竞争激烈
下一代光刻机一定由中国首先开发出来
ASML麻烦了?英国电子束光刻机,绕过EUV,制造5nm芯片
新一轮EUV光刻机争夺战开打
5nm单次曝光!ASML开始研发新一代Hyper NA EUV光刻机
2亿一台嫌贵?佳能说我这十分之一!光刻机价格战要来了?
网址: 下一代EUV光刻机,要来了 http://m.xishuta.cn/newsview147431.html
